服務熱線
0755-83044319

發布時間:2025-06-17作者來源:薩科微瀏覽:798
一、什么是劃片(Wafer Saw)?
劃片,是指將一整片晶圓(Wafer)上已加工好的成百上千顆芯片(Die),按照既定的劃線,將它們切割成獨立顆粒狀芯片的過程。
簡單來說,就是把一整塊“蛋糕”精準地切成一小塊一小塊,方便后續逐顆封裝。
二、劃片的目的與意義
實現芯片分離:晶圓初期是整片的,但每顆芯片要單獨封裝、測試,必須分離。
利于封裝操作:每顆芯片需要單獨處理、電性測試、封裝成品,必須通過劃片完成拆分。
提高良率與可靠性:精細控制的劃片過程可以減少邊緣破損,提高最終封裝成功率。
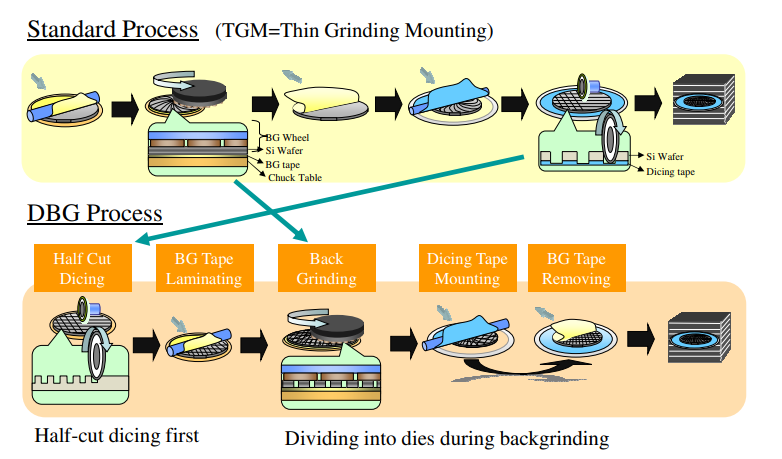
劃片并不是簡單的“切”,它是一門精密的工藝,下面是關鍵參數:


晶圓經過貼膜工藝,已被固定在藍膜上,藍膜安裝在金屬框架上,待入劃片機。
劃片設備依據芯片排列圖,設定劃線路徑,確保沿著“街道線”(scribe line)切割,不傷到芯片區域。
普通刀片用于大部分標準芯片
激光切割適用于高精度、小間距、堆疊結構芯片
刀片開始旋轉,并沿著設定軌跡緩慢推進
同時噴灑超純水,帶走切削粉塵,冷卻刀具
一般一顆晶圓需切割數十至上百條線
切割深度需精準控制,不能穿透藍膜,否則芯片會散落,無法進行下一步封裝。
適用于超小芯片、超窄劃線(cutting lane)、或三維堆疊封裝
優勢:無機械應力、切割精度高、切割寬度小
有些芯片為保護表層結構,需進行“雙次切割”:
[敏感詞]次用寬刀片清除表層保護層
第二次用窄刀片完成精準切割

清洗芯片表面
沖洗掉劃片后殘留的硅粉和顆粒
確保打線鍵合區無異物污染
水中加藥劑
有時在純水中加入化學清洗劑或二氧化碳氣泡,提高清潔效果,避免殘留物干擾后續封裝。
劃片是將晶圓上成百上千顆芯片精準切割成單顆的重要步驟,它是良率控制的關鍵節點之一。核心要點:

免責聲明:本文采摘自“老虎說芯”,本文僅代表作者個人觀點,不代表薩科微及行業觀點,只為轉載與分享,支持保護知識產權,轉載請注明原出處及作者,如有侵權請聯系我們刪除。
友情鏈接:站點地圖 薩科微官方微博 立創商城-薩科微專賣 金航標官網 金航標英文站
Copyright ?2015-2025 深圳薩科微半導體有限公司 版權所有 粵ICP備20017602號